倒装芯片芯片的锡球是怎么制作的?
倒装芯片中的锡球主要通过丝网印刷、激光植球和电镀三种工艺制作,具有导电、散热和支撑三大功能。丝网印刷成本低但均匀性较差;电镀法可制作小锡球且均匀性好;激光植球精度高但设备昂贵。不同工艺适用于不同生产需求,共同确保芯片性能稳定。
·
知识星球(星球名:芯片制造与封测技术社区,星球号:63559049)里的学员问:倒装芯片芯片的锡球是怎么制作的?麻烦讲解下具体的工艺
倒装芯片中锡球的作用?
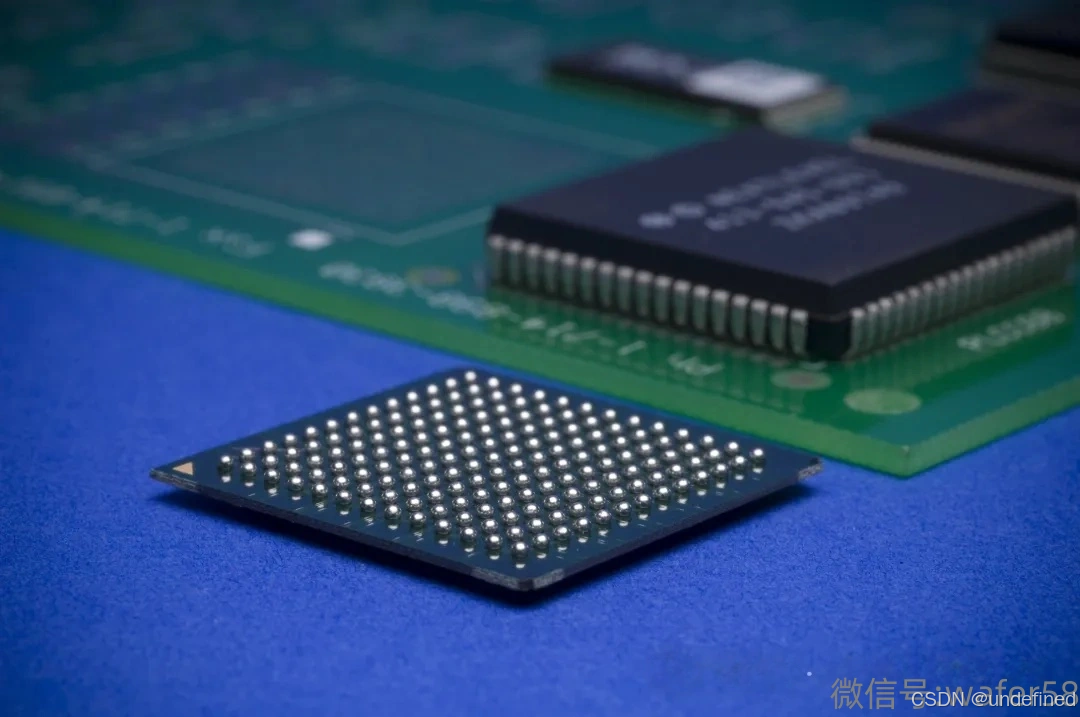
如上图,锡球,英文名称solder ball,是倒装工序中十分重要的部件,主要的作用有:
1,导电作用,用于连接芯片的焊盘和封装的基板,从而实现芯片与外部之间的信号传输。
2,散热作用,将芯片工作过程中产生的热量传导至基板
3,支撑作用
锡球的制作工艺?
一般有三种方法:丝网印刷,激光植球,电镀。
丝网印刷
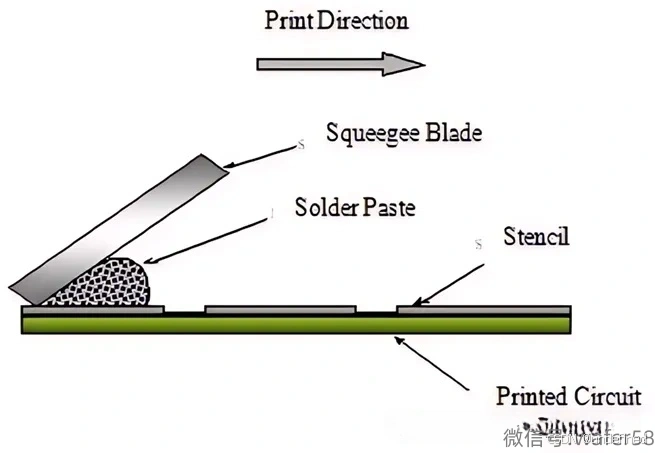
将锡膏通过钢网模板印刷到基板焊盘上,回流焊加热锡膏至熔融状态,在表面张力作用下形成球形。
电镀锡球
详见之前的文章:《聊聊倒装芯片(flip chip)的工艺流程》
激光植球
购买已经做好的锡球,将锡球储存于机台中,通过N₂将锡球输送到焊盘的指定位置,再用激光对锡球进行加热,锡球冷却后即芯片牢牢结合。
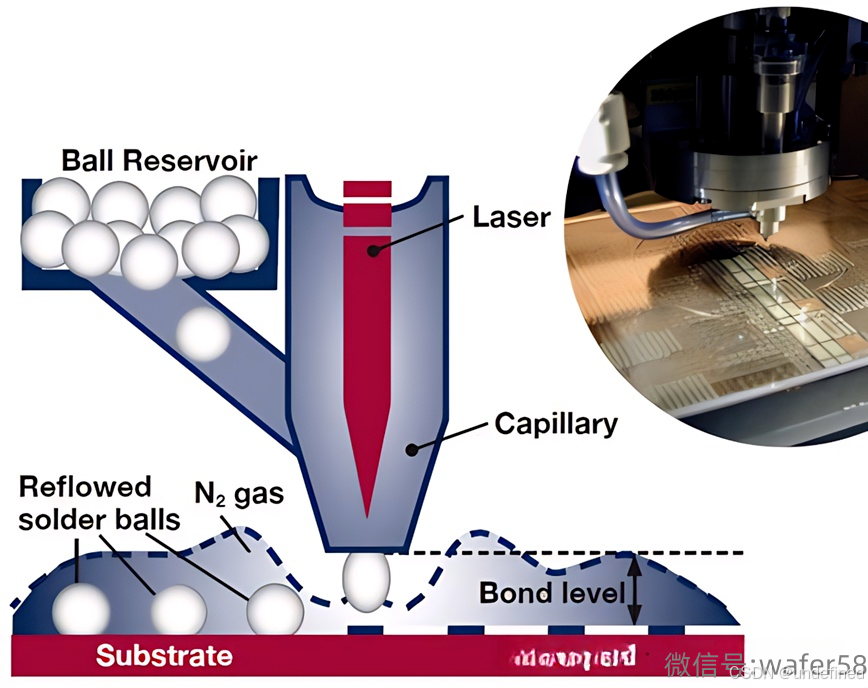
三种制作方法的对比?
印刷法:工艺简单成熟,成本低,难以实现超小锡球,均匀性较差,尺寸一般在100-150um左右。
电镀法:均匀性好,可以做小锡球,
激光植球:设备昂贵,效率低

魔乐社区(Modelers.cn) 是一个中立、公益的人工智能社区,提供人工智能工具、模型、数据的托管、展示与应用协同服务,为人工智能开发及爱好者搭建开放的学习交流平台。社区通过理事会方式运作,由全产业链共同建设、共同运营、共同享有,推动国产AI生态繁荣发展。
更多推荐
 已为社区贡献19条内容
已为社区贡献19条内容







所有评论(0)