ansys workbench 芯片回流焊,温度循环热应力仿真分析,有录屏,案例分析
本文档基于Ansys Workbench软件环境,对芯片回流焊与温度循环热力耦合仿真相关代码进行功能解读。该代码体系围绕热力耦合分析核心需求,构建了包含材料参数定义、几何模型导入、仿真流程配置及结果输出的完整技术框架,支持从热分析到结构应力分析的全流程自动化仿真,适用于芯片封装工艺中的可靠性评估场景,可精准模拟回流焊过程中的温度场分布与温度循环下的结构应力变化,为芯片封装设计优化提供数据支撑。
ansys workbench 芯片回流焊,温度循环热应力仿真分析,有录屏,案例分析
一、文档概述
本文档基于Ansys Workbench软件环境,对芯片回流焊与温度循环热力耦合仿真相关代码进行功能解读。该代码体系围绕热力耦合分析核心需求,构建了包含材料参数定义、几何模型导入、仿真流程配置及结果输出的完整技术框架,支持从热分析到结构应力分析的全流程自动化仿真,适用于芯片封装工艺中的可靠性评估场景,可精准模拟回流焊过程中的温度场分布与温度循环下的结构应力变化,为芯片封装设计优化提供数据支撑。
二、核心功能模块解析
(一)项目基础配置模块
该模块通过XML格式的项目配置文件(123.wbpj)搭建仿真项目的底层框架,定义了项目版本、工具版本及核心组件关联关系,是整个仿真流程的“骨架”。
- 项目信息定义
- 明确项目基于Ansys Workbench 2021 R1版本开发,框架构建版本为21.1.216.0,确保仿真过程中各工具模块的兼容性。
- 记录项目最后保存时间(2022年5月13日)及日志存储路径,便于后期追溯仿真过程中的操作记录与问题排查。 - 核心组件注册
- 注册了工程数据(Engineering Data)、几何(Geometry)、模型(Model)、设置(Setup)、求解(Solution)、结果(Results)六大核心组件,各组件通过唯一标识符关联,形成“数据-模型-求解-结果”的完整链路。
- 定义了瞬态热分析(Transient Thermal)、瞬态结构分析(Transient Structural)等仿真模板,为不同类型的分析任务提供基础计算框架。
(二)材料参数配置模块
材料参数是热力耦合仿真准确性的核心保障,该模块通过Journal脚本(journal1.wbjn、journal2.wbjn)实现了多种关键材料的参数定义与修改,覆盖芯片封装常用材料类型。
- 核心材料类型及参数
- Sn3.0Ag0.5Cu(无铅焊料):作为芯片与基板连接的关键材料,脚本中定义了其黏塑性(Anand模型)、密度、热导率、比热容、热膨胀系数等参数。其中黏塑性参数通过多组变量赋值(如初始变形阻力21MPa、硬化/软化常数180000MPa等),精准模拟焊料在高温回流焊过程中的塑性变形特性;热物理参数(如密度7.37g/cm³、热导率58W/(m·K))则保障温度场计算的准确性。
- FR4(基板材料):定义了密度(1.859-1.959g/cm³)、弹性模量(11000MPa)、泊松比(0.28)、热膨胀系数(1.36×10⁻⁵K⁻¹)等参数,匹配实际基板在温度变化下的力学与热学响应特性。
- 塑封料(suliaofeng):配置了密度(1.82g/cm³)、弹性模量(8700MPa)、热导率(0.5W/(m·K))等参数,用于模拟芯片封装外层保护材料的热力行为。 - 参数配置逻辑
- 通过CreateMaterial函数创建材料实例,CreateProperty函数为材料添加具体属性(如黏塑性、密度),SetData函数赋值参数值并指定单位(如MPa、K、W/(m·K)),确保参数维度统一。
- 支持参数修改与更新,如journal2.wbjn中调整Sn3.0Ag0.5Cu的弹性模量至30000MPa、热膨胀系数至2.47×10⁻⁵K⁻¹,以适配不同仿真场景需求。
(三)几何模型导入与处理模块
该模块负责将外部几何模型导入仿真环境,为后续网格划分与仿真计算提供实体模型基础,关键操作集中在Journal脚本(journal4.wbjn)与几何文件(回流焊模型.xt、温度循环模型.xt)中。
- 模型文件类型与来源
- 采用Parasolid格式(.xt)的几何文件,该格式支持跨CAD软件数据传输,确保模型拓扑结构与尺寸精度无损失。其中“回流焊模型.xt”对应回流焊工艺仿真,“温度循环模型.x_t”对应温度循环可靠性测试仿真。
- 模型文件包含芯片、基板、焊球、塑封料等关键结构,通过SOLIDWORKS 2020创建并导出,符合芯片封装的实际结构设计。 - 导入与刷新流程
- 通过SetFile函数指定几何文件路径(如E:/xianyuxiangmu/回流焊+温度循环热力耦合分析/热力耦合作业1/回流焊模型.x_t),将外部模型导入Geometry组件。
- 调用Refresh函数更新模型组件(Model Component),确保几何数据与工程数据(材料参数)正确关联,为后续网格划分与边界条件设置做好准备。
(四)仿真流程配置模块
该模块是热力耦合分析的核心,通过Journal脚本配置热分析与结构分析的关联流程,实现“热-力”数据的传递与耦合计算。
- 瞬态热分析配置
- 基于“Transient Thermal (ANSYS)”模板创建热分析系统(SYS),定义温度加载曲线(如回流焊过程中的升温-保温-降温阶段)、边界条件(如对流换热系数、热辐射参数)。
- 通过Setup组件设置时间步长、求解精度等参数,确保温度场随时间变化的计算准确性,为后续结构分析提供温度载荷数据。 - 瞬态结构分析配置
- 基于“Transient Structural (ANSYS)”模板创建结构分析系统(SYS 3),通过ComponentsToShare函数共享工程数据(材料)与几何模型,避免重复建模。
- 关键步骤是通过DataTransferFrom函数将热分析的温度结果(Solution组件输出)作为结构分析的温度载荷,实现热力耦合,模拟温度变化引起的热应力与变形。 - 求解与结果更新
- 调用Update函数触发求解过程,支持全依赖项更新(AllDependencies=True),确保材料参数、几何模型、边界条件的修改同步至求解环节。
- 通过Edit函数进入求解与结果组件,配置应力、应变、位移等结果输出项,为后续结果分析提供数据支撑。
(五)结果处理与输出模块
该模块负责仿真结果的更新与存储,确保分析结果可追溯、可复用,关键操作在Journal脚本(journal3.wbjn、journal4.wbjn)中体现。
- 结果更新
- 调用resultsComponent.Update函数更新结果组件(Results),将求解得到的温度场、应力场、位移场等数据生成可视化结果(如云图、曲线)。
- 支持多系统结果同步更新,如同时更新温度循环仿真(SYS 1)与结构分析(SYS 3)的结果,便于对比不同场景下的仿真数据。 - 文件存储与管理
- 仿真过程中生成的工程数据文件(如material.engd)、力学模型文件(如SYS.mechdb)存储在项目指定路径(如$(ProjectName)_files\dp0\global\MECH\),确保数据结构化管理。
- 通过Save函数保存项目文件(Overwrite=True),覆盖旧版本文件,避免数据冗余,同时支持项目文件的备份与迁移。
三、仿真流程逻辑
(一)回流焊仿真流程
- 初始化与材料配置:创建瞬态热分析系统,定义Sn3.0Ag0.5Cu、FR4、塑封料等材料的热学与力学参数。
- 几何导入与预处理:导入回流焊模型.x_t,刷新模型组件,确保材料与几何结构正确关联。
- 热分析设置与求解:配置回流焊温度曲线(如升温至250℃、保温5分钟、降温至室温),设置对流边界条件,执行瞬态热分析,得到温度场分布。
- 结构分析耦合:创建瞬态结构分析系统,导入热分析的温度结果作为载荷,设置约束条件(如基板固定),求解热应力与变形。
- 结果输出与分析:生成焊球、基板的应力云图与位移曲线,评估回流焊过程中是否存在过应力导致的结构失效风险。
(二)温度循环仿真流程
- 材料参数调整:基于回流焊仿真的材料基础,修改部分参数(如Sn3.0Ag0.5Cu的弹性模量),适配温度循环场景。
- 几何模型切换:导入温度循环模型.x_t,该模型可能包含更多循环测试相关的结构细节(如焊点阵列优化设计)。
- 循环载荷设置:配置温度循环曲线(如-40℃至125℃,循环1000次),设置循环步长与求解精度。
- 热力耦合求解:将每次循环的温度变化作为载荷输入结构分析,计算循环过程中的累积应力与疲劳损伤。
- 可靠性评估:输出循环后的最大应力、塑性应变数据,结合材料疲劳模型,评估芯片封装的寿命与可靠性。
四、关键技术特点
- 模块化与可复用性:将材料配置、几何处理、仿真求解拆分为独立模块,支持模块复用(如材料参数可直接用于不同仿真项目),降低重复开发成本。
- 热力耦合准确性:通过数据传递机制(DataTransferFrom)实现热分析与结构分析的紧密耦合,确保温度载荷精准传递,提高热应力计算的准确性。
- 自动化与脚本化:基于Journal脚本实现全流程自动化操作,减少手动设置误差,同时支持脚本修改以适配不同芯片封装设计(如调整焊球尺寸、材料类型)。
- 兼容性与可扩展性:支持Parasolid几何格式导入,兼容主流CAD软件;支持ANSYS与ABAQUS等不同求解器切换,可根据仿真需求选择合适的计算工具。
五、应用场景与价值
- 芯片封装设计优化:通过仿真预测回流焊过程中的温度分布与应力集中区域,优化焊球布局、基板厚度等设计参数,避免结构失效。
- 工艺参数验证:模拟不同回流焊温度曲线(如升温速率、保温时间)对封装结构的影响,确定最优工艺参数,降低实际生产中的工艺风险。
- 可靠性评估:通过温度循环仿真,评估芯片在长期使用过程中的疲劳寿命,为产品可靠性设计提供数据支撑,减少物理测试成本。
- 故障排查与改进:针对实际应用中出现的封装失效问题(如焊球开裂),通过仿真复现失效场景,分析失效原因并提出改进方案(如更换材料、优化结构)。
六、注意事项
- 参数单位一致性:仿真过程中需确保材料参数单位统一(如应力单位为MPa、长度单位为mm),避免单位不匹配导致的计算错误。
- 几何模型质量:导入的.x_t文件需确保无拓扑错误(如面重叠、缝隙),否则会影响网格划分质量,进而导致求解收敛困难。
- 求解收敛性控制:瞬态分析中需合理设置时间步长(如温度剧烈变化阶段减小步长),结构分析中需检查网格密度是否满足应力梯度计算需求,确保求解收敛。
- 结果有效性验证:仿真结果需结合实际测试数据(如物理实验的温度测量、应力测试)进行验证,修正材料参数或边界条件,提高仿真模型的可信度。
ansys workbench 芯片回流焊,温度循环热应力仿真分析,有录屏,案例分析

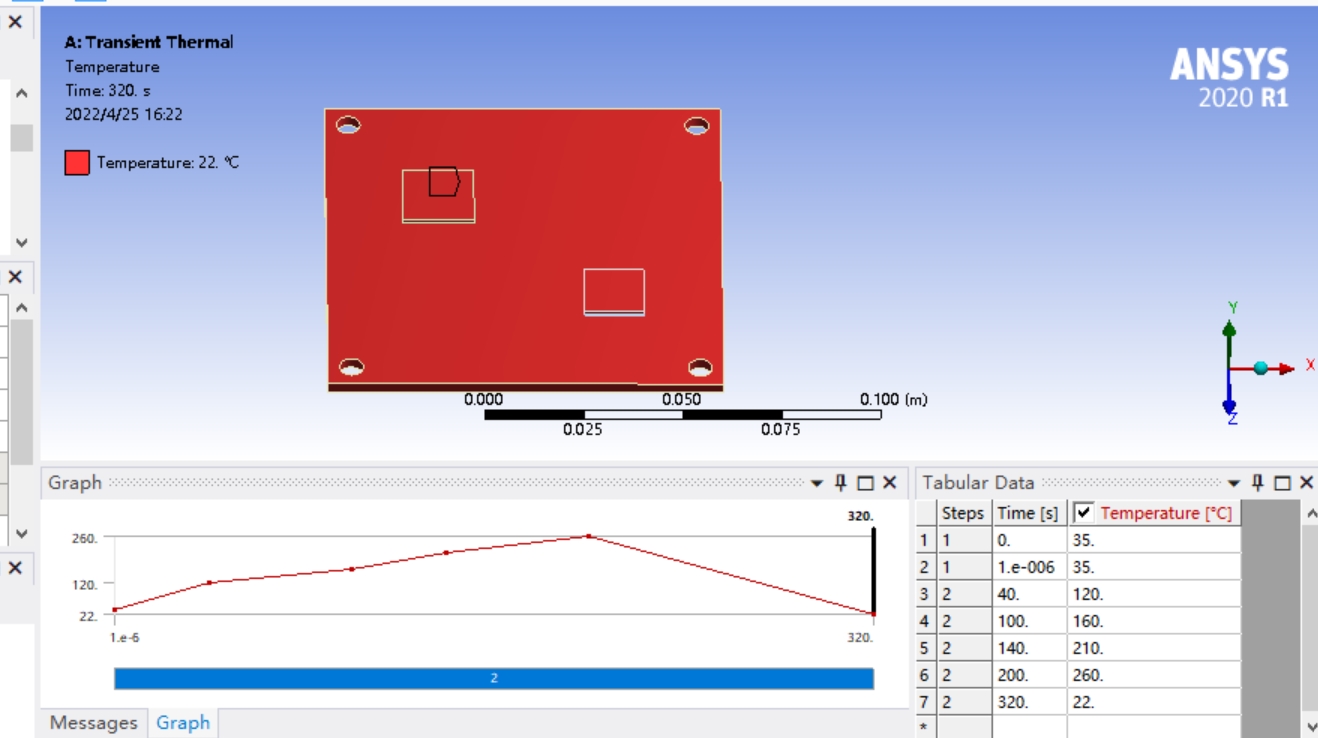


魔乐社区(Modelers.cn) 是一个中立、公益的人工智能社区,提供人工智能工具、模型、数据的托管、展示与应用协同服务,为人工智能开发及爱好者搭建开放的学习交流平台。社区通过理事会方式运作,由全产业链共同建设、共同运营、共同享有,推动国产AI生态繁荣发展。
更多推荐
 已为社区贡献1条内容
已为社区贡献1条内容








所有评论(0)