芯片制造的常见工艺之APCVD
APCVD(常压化学气相沉积)是一种在常压下进行的气相沉积技术,无需真空设备。该技术主要用于微电子器件中沉积绝缘层(如SiO2)和导体层(如多晶硅),也可用于传感器制造。APCVD具有高沉积率、设备简单等优点,但存在非均匀性较差、表面粗糙度高、温度限制和污染风险等缺点。典型工艺包括使用硅烷和氧气反应沉积SiO2,通过添加不同气体可获得PSG或BPSG等特殊材料。该技术广泛应用于电子元件隔离和晶体管
APCVD(Atmospheric Pressure Chemical Vapor Deposition),即常压化学气相沉积。顾名思义,与其他常见的气相沉积方法相比,APCVD的主要特点是在常压条件下进行,无需使用高真空设备。APCVD会在晶圆或其他类型的基板上沉积一层通常为几微米厚的材料。

APCVD的应用:
在微电子器件中,APCVD可用于沉积绝缘层,如二氧化硅(SiO2)。二氧化硅常用作绝缘层,用于隔离电气隔离度不同的电子元件和导线,它可以防止电流泄漏和相互干扰,确保电路的可靠性和稳定性。
APCVD还可用于沉积导体层,如多晶硅(poly-Si)。多晶硅常用作导体层,用于制造电极、连接线和晶体管等部分。它具有较高的导电性能和良好的可加工性,可以提供电流传输和信号传输的功能。多晶硅可用于制造晶体管的通道区域。在MOS(金属-氧化物-半导体)结构中,多晶硅作为晶体管的主要材料,提供电流传输和电子控制的功能。

在传感器制造中,APCVD可用于沉积保护层或选择性吸附层,以增强传感器的性能和稳定性。例如,沉积氮化硅(SiNx)用于传感器的防护层,或者沉积金属氧化物用于增加传感器的灵敏度。
APCVD的优点:
高沉积率:一般的沉积速率在几十到几百纳米每分钟,
机台结构简单:APCVD是在常压下的CVD反应,故不需要真空腔室。在此过程中使用“冷壁反应器”。使用通过射频感应加热的石墨基座仅加热晶圆。只有基座和晶圆是热的,这最大限度地减少了反应器壁上的沉积。为了在晶片或基板上实现均匀沉积,基板在沉积过程中经常移动。这通常是通过将基板放在柔性金属带上来实现的,传送带始终运行,使用滚轮装载和卸载晶圆。
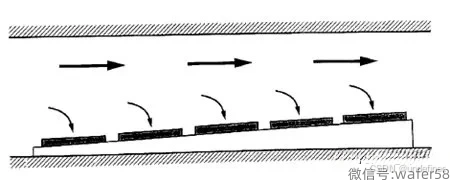
APCVD缺点:
非均匀性较差:在大气压下进行沉积时,由于气体扩散和传输的限制,沉积薄膜的厚度和质量在衬底表面上可能存在一定的非均匀性。这可能导致器件性能的变异性和不一致性。
较高的表面粗糙度
APCVD沉积的薄膜通常具有较高的表面粗糙度。这主要是由于在大气压下进行沉积时,气体分子碰撞和反应速率较慢,导致形成的薄膜表面不够平滑。 温度限制:
温度限制:
由于APCVD是在大气压下进行的,需要较高的温度来促进气相反应和沉积。这可能对一些热敏感的材料和器件造成限制。
污染风险
在大气压下进行沉积可能会引入外部杂质和污染物,如空气中的水分、氧气和有机物。这些污染物可能对薄膜的质量和性能产生不利影响。
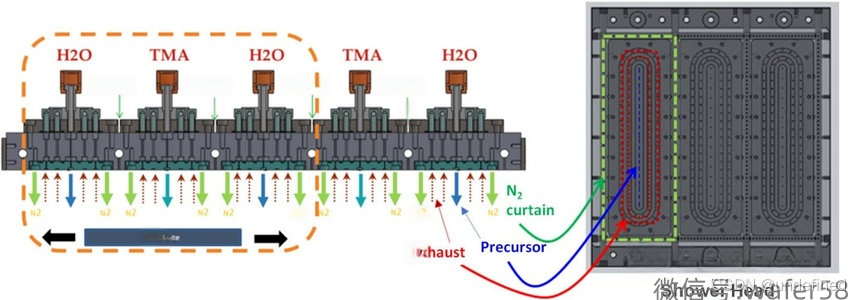
APCVD沉积SIO2工艺:
可使用硅烷 SiH 4(用氮气 N2高度稀释)和氧气 O2作为工艺气体。这些气体在约 400 °C 时热分解,并相互反应形成所需的薄膜。
SiH 4 + O 2 → SiO 2 + 2H 2 (T = 430 °C, p = 10·5°Pa)
可添加臭氧O 3得到更好的一致性,因为它提高了累积颗粒的可移动性。
如果需要得到PSG(Phosphosilicate Glass),则需将磷化氢添加到SiH 4和O 2中,使得沉积的氧化物含有4至8%的磷。大量的磷会导致流动性能的大幅提高。
如果需要得到 BPSG (Boron Phosphosilicate Glass),则需要同时通入磷化氢与B2H6来制备。
转载需注明出自本处。

魔乐社区(Modelers.cn) 是一个中立、公益的人工智能社区,提供人工智能工具、模型、数据的托管、展示与应用协同服务,为人工智能开发及爱好者搭建开放的学习交流平台。社区通过理事会方式运作,由全产业链共同建设、共同运营、共同享有,推动国产AI生态繁荣发展。
更多推荐
 已为社区贡献19条内容
已为社区贡献19条内容







所有评论(0)